チップレット相互接続のEliyanが資金調達、これまでの調達総額が144億円超に

チップレット相互接続技術を有するEliyanは2024年8月13日、ベンチャーキャピタル(VC)のVentureTech Allianceから戦略的投資を受けたことを発表した。金額は非公表。
Eliyanは、2021年に設立したスタートアップで、本社はカリフォルニア州サンタクララにある。
創業者はRamin Fajadrad氏、Patrick Soheili氏、Syrus Ziai氏の3名で、いずれも半導体業界のベテランである。
画期的なダイツーダイ相互接続アーキテクチャを開発
Eliyanのコアテクノロジーである「NuLink」は、半導体の物理層の実装を担う設計技術。同社のソリューションは、革新的なチップレット向けDie-to-Die(D2D)相互接続アーキテクチャにより他の技術では実現できないパフォーマンス、電力、面積効率を達成している。
チップレットとは、大規模回路を個片化する技術のことである。大規模な回路を機能ごとに分割し、複数の小さなチップ(チップレット)として製造し、これらを組み合わせて、1つの大きなチップのように機能させることができる。また、D2Dの「Die」は、半導体チップの最小単位のこと。そして、D2D相互接続アーキテクチャは、同一パッケージ内の複数の半導体チップ間でデータを転送するための高性能な通信インターフェースである。
「NuLink」のD2D相互接続は、UCleおよびBoWに準拠している。UCIe (Universal Chiplet Interconnect Express) は、半導体チップレット間の相互接続を標準化するオープン規格である。一方、BoW (Bunch of Wires)はチップレット間の相互接続基盤を定義付ける規格である。
2024年2月5日、同社はマルチダイアーキテクチャ向けでは業界最高性能である物理層ソリューションの設計工程の完了を発表した。このソリューションは、標準パッケージングを使用した 3nm プロセスで 64Gbps/バンプの帯域幅を達成。3nmプロセスとは、半導体製造における最先端の微細化技術である。「64Gbps/バンプ」とは、1つのバンプ(接続点)あたり64Gbpsのデータ転送速度を実現できることを意味する。つまり、非常に高密度かつ高速な接続が可能ということだ。
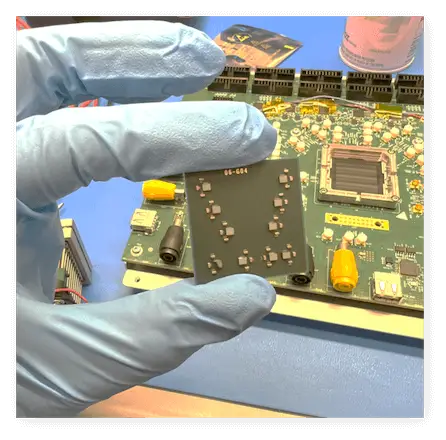 Eliyanが開発したチップ(Eliyanメディアキットより)
Eliyanが開発したチップ(Eliyanメディアキットより)
資金調達の目的は商業化プロセスと製品ラインの拡大
今回調達した具体的金額は明らかになっていないものの、VentureTech Allianceからの資金によりEliyanの調達総額は$100m(約144億円)を超えたとしている。
資金は、「営業、マーケティング、管理部門の企業インフラの拡大」「D2D、ダイツーメモリ(D2M)、チップツーチップ(C2C)相互接続の製品ラインの拡充」「カスタムおよび標準メモリとIOサブシステムチップレットのシリーズの開発」に活用されるという。
Eliyanの共同創業者兼CEOであるRamin Fajadrad氏は、次のようにコメントした。
「Eliyanは、先進的パッケージングと標準パッケージングの両方を活用した最先端の製造プロセスを開発した。実証した価値提案と技術的差別化は、AIチップエコシステム全体に波及している。世界有数のファウンドリやメモリサプライヤーから、このように広範囲にわたる財政的、戦略的サポートを受けることができてうれしく思う」
【世界の半導体の技術動向調査やコンサルティングに興味がある方】
世界の半導体の技術動向調査や、ロングリスト調査、大学研究機関も含めた先進的な技術の研究動向ベンチマーク、市場調査、参入戦略立案などに興味がある方はこちら。
先端技術調査・コンサルティングサービスの詳細はこちら
CONTACT
お問い合わせ・ご相談はこちら









